アーカイブ情報
2024/4/30
【バンプ保護フィルム】リンテック、半導体ウェハに形成したバンプ(突起電極)の損傷を抑制し、耐久性や信頼性を向上
リンテックは半導体ウェハに形成したバンプと呼ばれる基板接続用の突起電極を樹脂で保護することで、半導体チップの耐久性や信頼性を向上させるバンプ保護フィルムを開発。5月1日から本格販売を開始する。

半導体チップの耐久性や信頼性向上に貢献
電子機器の小型化・軽量化・高機能化が進む中、そこに搭載される半導体パッケージにも小型化・軽量化や基板への高密度実装が求められている。このような背景を受けて、近年では「Wafer Level Chip Scale Package(WLCSP)」と呼ばれるパッケージング技術が注目されている。従来のパッケージング工程では、ウェハの切断を行った後に取り出した半導体チップを基板に固定して、ワイヤー接続や樹脂封止などを行うのに対し、WLCSPはウェハ上でこうしたパッケージとしての処理を加え、最終的にウェハを切断した後、基板に直接チップを実装する。チップの大きさがそのままパッケージとなり、小型化・軽量化を実現できることから、スマートフォンやPCにもこの技術が採用されている。
WLCSPは構造上、基板接続用の電極として突起状のバンプが形成されており、熱による変形や応力などの負荷が掛かると、この部分にクラック(亀裂)が生じてしまう。リンテックでは突起状の電極を樹脂で保護することでこれを抑制し、半導体チップの耐久性や信頼性を向上させるバンプ保護フィルムを開発した。
新たな装置の導入や製造プロセスの変更が不要
今回開発したバンプ保護フィルムは、温度によって樹脂の粘度が変化する設計になっており、バンプを形成した回路面に加熱しながら貼付することで、空気が入ることなく凹凸面に追従させることが可能。また、このフィルムはバックグラインド(ウェハ裏面を研削し、薄型化する)工程の際に表面を保護し、研削水・研削屑の浸入による回路面の汚染を防ぐ機能も兼ね備えている。
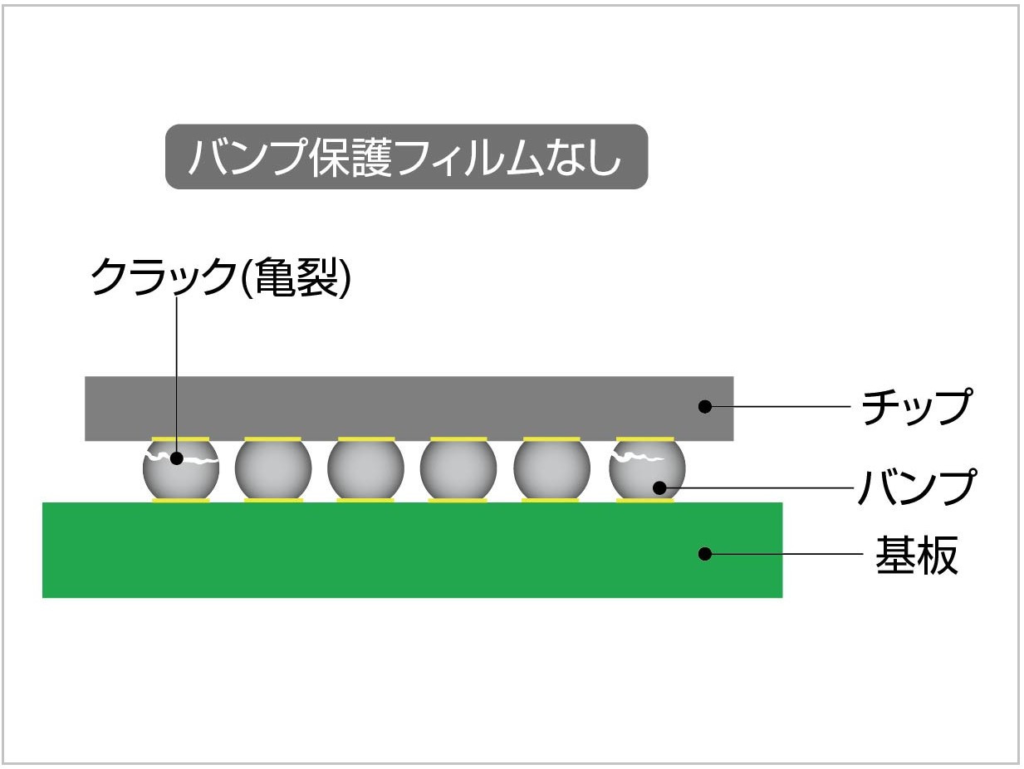

(バンプ保護フィルムの貼付イメージ)
そして、バックグラインド工程の後、このフィルムの表層を剥がすとバンプを保護する樹脂のみが残る仕様になっている。新たな装置の導入や製造プロセスの変更を必要とせず、またフィルム自体はバンプの形状や大きさの違いに応じたカスタム対応も可能。リンテックでは今後も、半導体チップの信頼性向上に貢献するテープや装置、製造プロセスの提案に努めていく。
「バンプ保護フィルム」製品概要は次の通り。
特徴
バンプと呼ばれる基板接続用の突起電極を保護することで、クラック(亀裂)の発生を抑制するフィルム。半導体チップの耐久性や信頼性の向上に貢献する。
温度によって樹脂の粘度が変化する設計になっており、バンプを形成した回路面に加熱しながら貼付することで、空気が入ることなく凹凸面に追従させることができる。
バックグラインドテープと一体型になっており、バックグラインド(ウェハ裏面を研削し、薄型化する)工程の際に表面を保護し、研削水・研削屑の浸入による回路面の汚染を防ぐ機能も発揮する。
新たな装置の導入や製造プロセスの変更を必要とせず、バンプの形状や大きさの違いに応じたカスタム対応も可能。
独自の発想が詰まった「チップ裏面保護テープ」も併せて提案
ウェハの状態でパッケージングまで行う「WLCSP」には、さまざまな実装方式があるが、フリップチップ実装と呼ばれる方式向けに開発した「チップ裏面保護テープ」はリンテックが特に高いシェアを誇っている。フリップチップ実装はバンプを形成した回路面を反転(フリップ)して、直接基板と接続するため、ワイヤーを用いた実装方式と比べて実装面積が小さくなるという利点があり、半導体チップのさらなる小型化・薄型化につながる。しかし、チップの裏面がむき出しになっているため、薄型化が進むにつれてその補強が不可欠となっている。このテープは、チップの裏面を保護・補強すると同時に、光などによる回路面への悪影響を低減する。また、テープ状であるため液状のものと比較して厚みの均一性を保つこともできる。リンテックでは、このテープと併せて新たに開発した表面(回路面)を保護する「バンプ保護フィルム」も提案し、チップの信頼性向上に貢献していく。
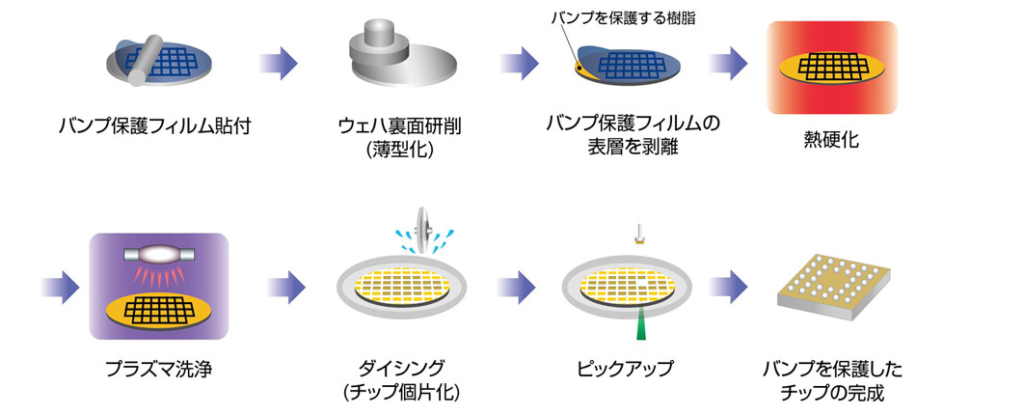
- カテゴリー
- コンバーティングプロダクツ&テクノロジー
- 注目

