アーカイブ情報
2025/6/27
【半導体】レゾナック、PulseForge、次世代半導体パッケージ向け光剝離プロセスで提携
レゾナックとPulseForge, Inc.は、2025年4月に、次世代半導体パッケージ向け光剝離プロセスに関する戦略的提携に合意した。同技術は、半導体デバイスの製造工程(前工程)や半導体パッケージング工程(後工程)において、ウエハ等をガラスなどのキャリアに一時的に固定するプロセスに関するもの。レゾナックの仮固定フィルムと、PulseForgeの光照射システムを組み合わせることで、半導体パッケージの高い歩留まりと生産性を実現する。
両社は、2026年内に同技術を量産プロセスへ導入することを目標として同提携を推進し、業界トップレベルのコスト効率を目指す。

AI(人工知能)向けなどの次世代半導体パッケージ)(*1)は、2.5Dや3Dといった複雑な構造(*2)のため、その製造プロセスには、歩留まりと生産性の向上が強く求められている。仮固定材は、ウエハやチップをガラスなどのキャリアに一時的に接着し、さまざまな環境下で実施される加工プロセスを経た後、ウエハやパッケージとともにキャリアから剥離される。このため、仮固定材には、あらゆる加工プロセスへ適合することに加えて、残った仮固定材を容易に除去できることが求められる。
PulseForgeは、独自の高いエネルギーを出力できる光照射システム、およびガラスキャリアを保有している。これにより、ウエハやパッケージに熱や物理的な負荷をかけることなく、短時間でキャリアから仮固定材を剥離できる。さらに、「すす」のような異物が発生せず、環境負荷の低減にも貢献する。この独自技術は、一般的なレーザー照射による剥離と比較し、高い歩留まりと生産性を実現し、コストの低減に貢献する。
レゾナックは、このPulseForgeの光照射システムを用いた光剥離プロセスに適した仮固定フィルムを開発した(*3)。このフィルムは、膜厚均一性に優れているほか、厚さ20 μmの超薄型ウエハにも対応している。また、同フィルムは、ウエハやパッケージから容易に除去できるため、洗浄プロセスを最小限に抑えることができる。
レゾナックは、この共創を支える光剝離プロセスに関する基本的な方法特許を保有している。レゾナックは、同共創においてPulseForgeが次世代プロセスを実現する上で独自の地位を築けるよう、この方法特許において使用される光源製品および当該光源製品を適用したデボンド(剥離)装置について、PulseForgeに対して独占的なライセンスを付与している。
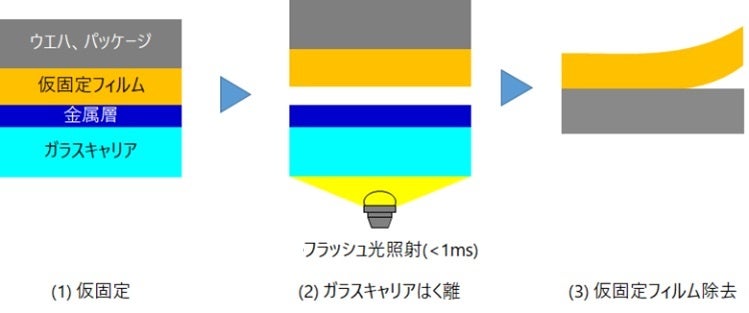

レゾナックとPulseForgeは、この提携により、アジア、北米およびヨーロッパにおける顧客対応、マーケティング活動を共同で実施する。また、技術面では、プロセスの統合、材料の適合性確保、同技術のグローバル展開支援において共創していく。
今回の提携について、レゾナック・ホールディングス 執行役員 半導体材料研究開発統括の阿部秀則氏は「この提携は、先端パッケージングの可能性を広げたい、という両社共通のビジョンに基づくものです。光剝離プロセスは、ロジックやメモリに対する次世代の要求に対応できる画期的なプロセスであると、私たちは考えています。」と述べている。
また、PulseForge CEOのJonathan Gibson氏は「レゾナックとの提携合意は、半導体製造をさらに発展させるという私たちのミッションにとって大きな一歩です。レゾナックは、材料イノベーションにおけるリーダーシップを取るとともに、強固なエコシステムと連携しており、光剝離プロセスの性能、信頼性、総所有コストにおける利点を実証するには理想的なパートナーです」と述べている。
*1 情報量の増大に対応するため高密度化、高集積化した半導体パッケージ。2.5D/3Dヘテロジーニアスインテグレーション(異種チップの統合)やWLP(ウエハレベルパッケージング)、チップレット、HBM(広帯域メモリー)などの高度な技術を採用。
*2 2.5Dは複数のチップをインターポーザーと呼ばれるシリコン基板上に実装する技術。3Dは複数のチップを積層する技術。
*3 2024.9.19 先端半導体パッケージ向け仮固定フィルムと剥離プロセスを開発
- カテゴリー
- news
- コンバーティングニュース

