アーカイブ情報
2025/2/13
【半導体】レゾナック、シミュレーションで次世代パッケージ向け低熱膨張銅張積層板開発
レゾナックは、半導体パッケージ大型化に伴う課題の1つである「反り」を抑制した、次世代半導体パッケージ向け低熱膨張銅張積層板を開発した。同製品の温度サイクル試験における寿命は従来比の4倍を実現し、100mm x 100mmを超える半導体パッケージにも対応。2026年の量産開始を目指す。
なお、本製品は、計算科学技術の1つである「マルチスケール解析(*1)」の応用により、銅張積層板を形成する各材料個別の設計指針を明確にし、開発した。レゾナックは、本技術を汎用的に利用できる物性可視化システムとして構築し、このたび社内へ導入した。
近年、次世代半導体のパッケージ基板は大型化する傾向にあるが、大型化に伴い、基板の反りが信頼性へ与える影響はより大きくなる。通常、基板の反りを抑制するため、基板のコア材料である銅張積層板の熱膨張係数(*2)を小さくすることが有効だが、この場合、温度サイクル試験の冷却時に、基板を構成する他の材料との熱膨張差により、クラックが発生しやすくなる。クラック低減にあたり、銅張積層板の設計指針(例えば、弾性率(*3)を低くする)は示すことができるが、銅張積層板は樹脂や無機材(ガラスクロス)など複数の材料から構成されており、各材料個別の設計指針にまで落とし込むことはできていなかった。
そこで、レゾナックの計算情報科学研究センターでは、銅張積層板の樹脂とガラスクロスから成るコア層に、スケールの異なる構造体同士の物性や挙動の相互作用を考慮できる「マルチスケールFEM解析(*4)」を適用。これにより、クラックが発生しやすい、コア層の樹脂にかかる局所的な応力を詳細に解析し、樹脂の特定の物性を制御することで、発生する応力を低減した銅張積層板を開発した。
また、同社は、本技術を活用して、汎用的な物性可視化システムを構築し、社内展開を開始した。このシステムでは、ユーザーが材料の物性を入力すると、目的特性(例えば、反り)がどのように変化するのか、その傾向を可視化することができる。銅張積層板に限らず、封止材やフィルム材料など複数材料から成る幅広い製品に対応しており、同社が強みとする半導体後工程製品を中心に活用を開始している。
半導体の技術革新加速に伴い、高性能な材料を迅速に提案することが求められている中、レゾナックは、計算情報科学研究センターのリソースの7割を半導体材料開発に投下し、成果を上げている。
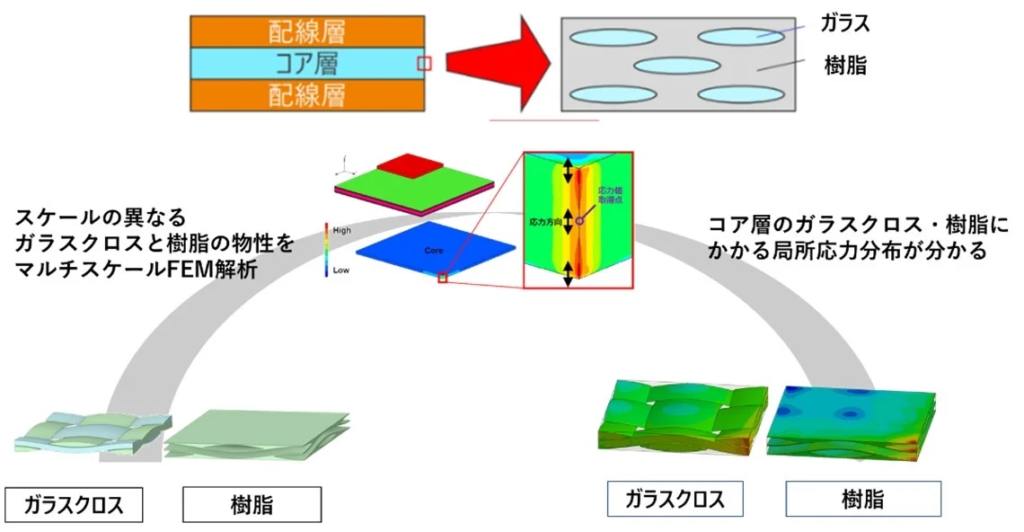


*1 スケールの異なる構造物双方の物性、もしくは挙動を連成させる解析のこと。複数の異種材料から成る複合材料の材料特性を均質化することで、材料全体の挙動を容易に把握できるようにする。
*2 物体は、温度の上昇によって体積や長さが膨張する(熱膨張)。熱膨張係数は、温度が1℃上昇すると体積や長さがどれくらい膨張するかを表したもので、材料固有の特性。
*3 材料の変形のしにくさ(材料のかたさ)を表す値。
*4 物体や構造物を小さな要素に分割し、それらの要素の性質を数値化して計算を行うことで、全体の挙動を解析する有限要素法(FEM:Finite Element Method)を、マルチスケール解析に適用したもの。
- カテゴリー
- コンバーティングニュース

