アーカイブ情報
2026/2/18
【半導体】リンテック、バックグラインド工程の歩留まり向上に貢献する樹脂塗布プロセスを開発
リンテックは半導体ウェハの裏面を研削するバックグラインド工程において、回路面の段差から生じる厚みのばらつきを改善する「PCBL(Pattern Coating Before Lamination)プロセス」を開発。段差を解消するために樹脂を塗布する新装置「RAD-3400F/12」の本格受注を4 月から開始する。
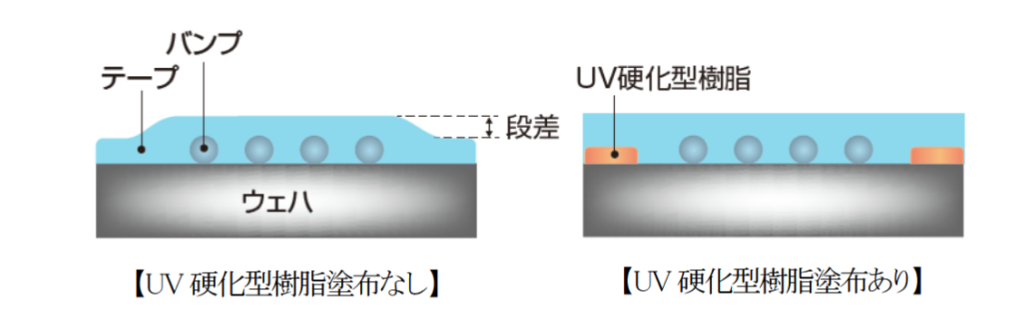
ウェハの厚みの差を低減する「PCBL プロセス」
半導体チップの微細化が進むにつれ、製造工程ではウェハの裏面を薄く平坦に研削するバックグラインド工程の重要性が高まっています。特にウェハ全体の厚みのばらつきを抑え、高い平坦性を確保することが半導体チップの品質向上に欠かせない。しかし、回路面にバンプと呼ばれる突起電極が形成されたウェハのように中央と外周部で高低差がある場合、ウェハ研削に当たり表面を保護する「バックグラインドテープ」を貼付した際、外周部に段差が生じ、これが研削時にクラック(欠けやひび割れ)が発生する原因にもなる。そこで同社は、バンプのない外周部に UV 硬化型の樹脂を塗布することでこの段差を解消し、ウェハ研削後の厚みのばらつきやクラックの発生を低減する「PCBL(Pattern Coating Before Lamination)プロセス」を新たに開発した。

仕様に合った樹脂塗布が可能な装置「RAD-3400F/12」
このプロセスにおいて、ウェハに樹脂を塗布する装置「RAD-3400F/12」を新たに開発。同装置は塗布する樹脂のパターンや塗布量、幅や高さを調整することで、バンプの高さなどウェハの仕様に合わせたカスタマイズが可能だ。また、樹脂の塗布後は、従来の製造ラインでバックグラインドテープを貼付して裏面研削を行い、研削後にテープを剥がすことで、樹脂とともに剥離できる。
同社は同装置および PCBL プロセスの提案を強化することで、半導体チップ製造における歩留まり向上へのさらなる貢献を目指していく。
- カテゴリー
- コンバーティングニュース

