アーカイブ情報
2025/8/8
【窒化スカンジウムアルミニウム】東京理科大学、スパッタ法を用いて高品質なScAlN薄膜の作製に成功
東京理科大学 先進工学部 マテリアル創成工学科の小林 篤准教授、太田隼輔氏(2024年度 学士卒業)らの研究グループは、スパッタ法を用いて、窒化スカンジウムアルミニウム(ScAlN)薄膜を高品質で作製することに成功した。これにより、小型で高性能な次世代トランジスタの開発に大きく貢献することが期待される。また、産業界で汎用されるスパッタ法を用いた薄膜作製技術は窒化物半導体材料全般に応用できる可能性を秘めており、エレクトロニクス分野全体にインパクトを与える重要な成果といえる。この成果は、東京大学(電気特性の測定補助および解析)、住友電気工業(HEMTウェハの作製)との共同研究によるもの。
ScAlNは、大きな圧電係数(*1)と自発分極(*2)を持ち、GaNベースの高電子移動度トランジスタ(HEMT,*3)のバリア材料として優れた2次元電子ガス(2DEG, *4)密度向上効果を示す。また、強誘電性により不揮発性メモリや多機能デバイスへの応用可能性も期待されている。一方で、Sc添加による結晶構造の乱れや界面品質の劣化が電子移動度の低下を引き起こすことが課題となっていた。また、従来法では高品質な膜が得られるものの、装置の複雑さや高いコストが産業応用の障壁となっていた。同研究グループは、より簡便で低コストなスパッタ法による高品質ScAlN薄膜成長技術の確立を目指して、研究を推進してきた。
同研究では、AlGaN/AlN/GaN/SiC基板上にScAlN膜をスパッタ法で成長させ、250~750℃の成長温度が膜質と電気特性に与える影響を調べました。表面分析の結果、成長温度の上昇とともに表面が平滑化し、750℃で最も平坦かつ高品質な膜が得られることが確認された。結晶構造解析では、ScAlN薄膜が全温度範囲で基板の格子定数と整合して成長し、温度が高くなるほどc軸の格子定数が減少することが明らかなった。電気特性評価では、750℃で成長させた薄膜構造のシートキャリア密度が約3倍に増加した。一方で、電子移動度は低下し、界面付近の負電荷が原因であることがシミュレーション解析により示唆された。
この研究成果から、成長温度がScAlN薄膜の品質と2DEG特性の両方を決定する重要な因子であることが実証され、高性能GaNデバイス開発への指針が得られた。また、産業的に汎用性の高いスパッタ法による高品質ScAlN成膜技術の確立により、次世代エレクトロニクスデバイスの実用化の加速が期待される。
同研究成果は、2025年8月7日に国際学術誌「APL Materials」にオンライン掲載され、注目度の高い論文として「Editor’s Pick」に選出された。
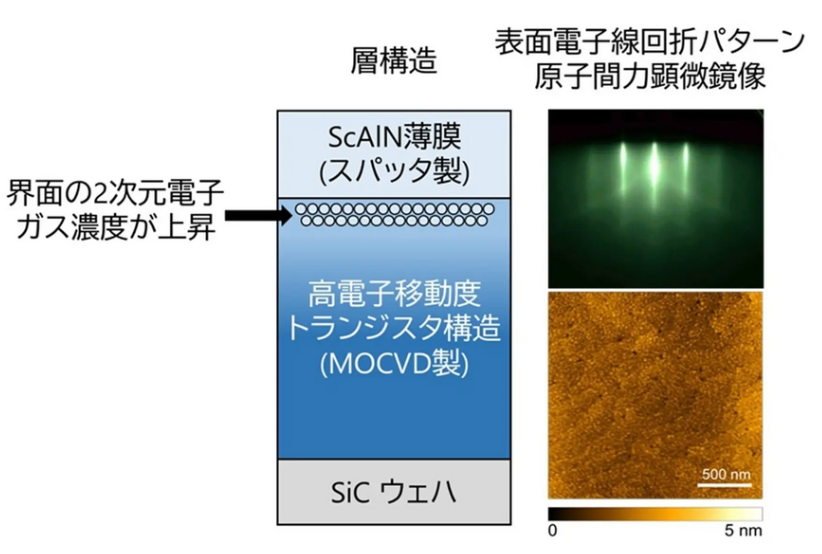
- カテゴリー
- コンバーティングニュース

